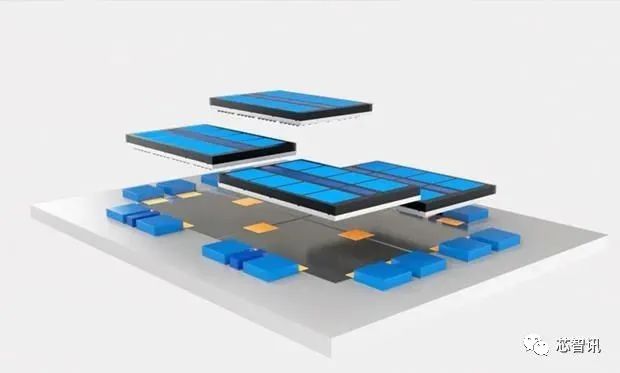
文章圖片
3月21日消息 , 由于3nm及更先進制程投資成本越來越高 , 為了繼續推進芯片整體性能和成本并降低成本 , 2.5D/3D先進封裝技術越來越受到產業界的青睞 , 并已進入高速成長期 。
根據市場研究機構Yole Developpement統計 , 英特爾及臺積電去年在先進封裝領域的資本支出居于領先地位 , 同時掌握了技術制定的話語權 , 日月光投控及三星則緊追在后 , 前四大廠廠商的資本支出合計占比高達85% 。
【英特爾|2.5D/3D先進封裝投資排名:英特爾第一,臺積電、日月光緊隨其后】
根據Yole Developpement數據顯示 , 去年全球2.5D/3D封裝前七大半導體廠資本支出合計達119.09億美元 , 其中 , 英特爾、臺積電、日月光投控排名前三大 , 三星及安靠(Amkor)緊追在后 , 大陸封測廠商長電科技及通富微電亦排名第六及第七 。
由于芯粒(chiplet)設計已成為未來高性能芯片的發展趨勢 , 2.5D/3D封裝資本支出在未來三年成長幅度將明顯拉高 。
Yole Developpement數據顯示 , 去年全球先進封裝市場規模達27.4億美元 , 2021~2027年的年復合成長率(CAGR)將達19% , 2027年市場規模會成長至78.7億美元 。
英特爾去年在2.5D/3D封裝領域的資本支出達35億美元 , 主要投入Foveros及EMIB等先進封裝技術研發及產能擴建 。 英特爾認為3D封裝能延續摩爾定律 , 給予設計人員橫跨散熱、功耗、高速信號傳遞和互連密度的選項 , 最大化和最佳化產品效能 。 其中 , 今年將推出的Sapphire Rapids服務器處理器及Ponte Vecchio數據中心GPU芯片 , 以及開始試產的Meteor Lake處理器都將采用Foveros技術 。
臺積電在2.5D封裝方面已推出CoWoS及InFO等技術并進入量產 , 去年2.5D/3D封裝資本支出達30.49億美元 , 位居全球第二 , 將擴大系統整合芯片(TSMC-SoIC)中多種3D Fabric平臺的WoW(晶圓堆疊晶圓)及CoW(芯片堆疊晶圓)先進封裝技術推進及產能建置 。
據了解 , 包括蘋果、聯發科、AMD、賽靈思、博通、英偉達等大客戶都已經采用臺積電的先進封裝技術 。
日月光投控去年在2.5D/3D封裝領域的資本支出達20億美元 , 排名第三 , 憑借在FoCoS先進封裝技術的布建 , 是目前在封測代工(OSAT)產業中唯一擁有超高密度扇出解決方案的業者 。
三星去年在2.5D/3D封裝領域的投資達20億美元 , 近期已計劃整合旗下封測相關資源加快先進封裝布局 , 以因應HPC應用在異質芯片整合的快速發展 。 安靠去年在2.5D/3D封裝領域的投資約7.8億美元 , 布局動作維持穩健 。
前五大廠累計在先進封裝的資本支出占了全球總投資的91% , 說明市場仍由一線大廠主導 。
編輯:芯智訊-林子 來源:工商時報
相關經驗推薦
- |反擊起效了!英特爾、AMD兩大美企“反水”,外媒:丟人現眼
- 英特爾|俄羅斯兩大“反擊”行動的展開,AMD和英特爾損失慘重
- 英特爾|折疊屏這幾年很火,我發現身邊越來越多的人在用折疊屏了!
- 英特爾|玩家有新選擇! Intel 首款 Arc 獨立顯示卡確定月底登場
- 英特爾|英特爾的 Arc A 系列GPU筆記本電腦將于3月30日推出
- Surface|看英特爾如何構建生態加速AI落地
- mac mini|蘋果Mac Studio 如何與配備齊全的(英特爾)Mac mini 相媲美?
- 耳機|AMD挖角Intel技術人才,擴展先進圖形運算應用發展
- 臺積電|臺積電、英特爾、三星3巨頭拼工藝、拼封裝,大陸廠商只能看戲
- 問界m5|怕了?英特爾AMD恢復供貨:成全了華為,不能再成全龍芯















